6세대 HBM4부터 진검 승부 본격화
양사 동작속도·대역폭, 국제 표준 상회
적층은 SK가 16단으로 12단 삼성 앞서
 |
| 22일 서울 강남구 코엑스에서 열린 ‘반도체대전(SEDEX) 2025’을 찾은 관람객이 삼성전자 부스(왼쪽)와 SK하이닉스 부스에서 6세대 고대역폭 메모리인 HBM4 실물을 살펴보고 있다. [연합] |
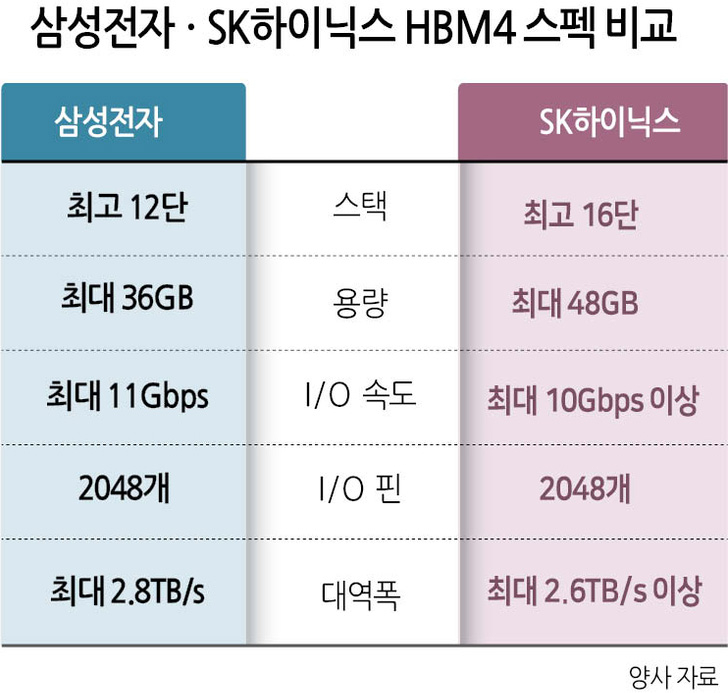 |
삼성전자와 SK하이닉스가 22일 서울 강남구 코엑스에서 막을 올린 제27회 반도체 대전(SEDEX 2025)에서 차세대 고대역폭메모리(HBM) 시장의 향방을 가를 6세대 제품 HBM4 실물을 나란히 공개했다.
양사는 모두 HBM4의 입출력(I/O) 최대 속도가 국제반도체표준협의기구(JEDEC)의 표준(8Gbps)보다 높은 점을 강조했다.
삼성전자는 최대 11Gbps의 동작속도를 구현했다고 명시해 앞서 10Gbps 이상이라고 밝힌 SK하이닉스와 비슷한 수준을 보였다.
동작속도란 메모리와 그래픽처리장치(GPU) 사이에서 데이터가 얼마나 빠르게 오갈 수 있는지 나타내는 지표다. 이 수치가 높아질수록 전체 대역폭과 GPU 성능이 크게 향상된다.
업계에 따르면 엔비디아는 HBM4를 만드는 메모리 업체들에게 국제반도체표준화기구(JEDEC)가 정한 8Gbps보다 더 높은 10Gbps 수준의 동작속도를 요구하고 있다.
삼성전자와 SK하이닉스는 이를 반영한 듯 자사 HBM4의 최대 동작속도를 강조하며 엔비디아 납품을 둘러싼 경쟁 의식을 드러냈다.
HBM4의 데이터 전송 통로인 I/O핀 수도 양사 모두 2048개로 동일하다. 삼성전자와 SK하이닉스는 메모리와 프로세서 간 데이터 전송 속도를 좌우하는 스택당 대역폭(1초당 처리할 수 있는 총 데이터 용량)이 각각 최대 2.8TB/s, 2.6TB/s라고 밝혀 JEDEC이 제시한 표준(2.0TB/s)을 모두 넘겼다.
그동안 HBM3E의 엔비디아 품질 테스트 과정에서 고전했던 삼성전자는 발열 논란을 의식한 듯 방열 성능을 강조했다. HBM4의 전력 효율이 HBM3E보다 40% 개선됐으며 동시에 데이터 전송과 열 분산을 돕는 범프 수를 1.2배 늘리고 열 저항을 11% 낮춰 방열 성능을 강화했다고 밝혔다.
앞서 SK하이닉스 역시 자사 HBM4의 전력 효율을 40% 이상 끌어올렸다고 강조한 바 있다. 얼마나 전기를 적게 소모하느냐가 AI 메모리 시장의 승부처로 통하는 가운데 양사가 같은 수준의 전력 효율을 내세운 셈이다.
적층(스택) 기술에서는 SK하이닉스가 우위를 보였다. SK하이닉스는 D램 칩을 16단으로 쌓아 올린 점을 강조해 12단을 적층한 삼성전자를 앞섰다.
여러 개의 D램을 수직으로 쌓아 올린 HBM은 엔비디아의 GPU 옆에 붙어 연산을 보조하는 역할을 한다. 기존 D램보다 데이터 처리 속도가 빨라 AI 서버처럼 대량의 데이터를 처리해야 하는 다양한 분야에서 수요가 폭증하고 있다.
반도체 업계는 엔비디아의 차세대 GPU 플랫폼인 ‘루빈’에 HBM4 12단 제품 8개가 탑재될 것으로 전망하고 있다. 엔비디아의 AI 가속기 트렌드가 내년 하반기를 기점으로 지금의 ‘블랙웰’에서 루빈으로 옮겨가면 주력 HBM도 HBM3E에서 HBM4로 세대교체될 것으로 예상된다.
지난해 5세대 제품인 HBM3E 8단·12단 제품을 가장 먼저 엔비디아에 납품했던 SK하이닉스는 HBM4 경쟁에서도 앞서 나가면서 HBM 시장 리더십을 공고히 유지할 것으로 평가 받는다.
곽노정 SK하이닉스 사장은 전날 열린 제18회 반도체의 날 기념식에서 기자들과 만나 HBM4에 대해 “고객들이 원하는 성능·속도 기준은 다 충족했고 양산성도 확보했다”고 말하며 자신감을 보였다.
곽 사장은 “(지금까지 수립한 계획을) 순조롭게 진행 중이다. 다음 주 실적 발표할 때 자세한 내용을 말씀드릴 것”고 밝혔다.
SK하이닉스는 AI 반도체 업계의 ‘큰손’인 엔비디아를 비롯한 주요 고객사 요구에 맞춰 HBM4를 적기에 대량 공급해 AI 메모리 시장에서 우위를 이어간다는 계획이다.
SK하이닉스와 마이크론이 10나노급 5세대(1b) 공정으로 HBM4를 제조한 반면, 삼성전자는 기술 난도가 더 높은 10나노급 6세대(1c) 나노 공정을 기반으로 HBM4를 개발해 역전을 노린다. 5세대 제품(HBM3E) 경쟁에서 밀리며 자존심을 구긴 만큼 HBM4에서는 반전을 모색하고 있다.
HBM의 가장 밑 부분인 베이스다이도 HBM4부터는 기존 D램 공정이 아닌 파운드리(반도체 위탁생산)의 초미세 공정을 활용해 만든다. 베이스다이는 그래픽처리장치(GPU) 등 여러 프로세서와 연결돼 통신하는 일종의 ‘두뇌’다.
파운드리의 초미세 로직 공정을 활용하면 전력 효율과 성능 향상은 물론 각 고객사 니즈에 맞춰 맞춤형 제품을 제공할 수 있는 것이 장점이다. SK하이닉스가 세계 1위 파운드리인 TSMC와 손을 잡았다면 삼성전자는 자체 파운드리 공정을 활용해 HBM4의 베이스 다이를 완성했다.
시장조사업체 카운터포인트리서치에 따르면, 올해 2분기 HBM 시장 점유율은 출하량 기준 SK하이닉스 62%, 마이크론 21%, 삼성전자 17% 순이었다. 다만 내년 HBM4 양산이 본격화되면 삼성전자의 점유율은 30% 수준까지 확대될 것으로 전망된다. 박지영 기자












